110nm 光刻工艺开放,微纳平台核心光刻能力再升级!
设备核心原理
ASML KrF 步进扫描光刻机基于深紫外(DUV)光刻技术,以氪氟化物(KrF)准分子激光为光源(波长 248nm),通过精密光学系统和运动平台将掩模版上的集成电路图案转移到涂有光刻胶的晶圆表面。系统采用Step & Scan(步进+扫描)曝光机制,通过掩模与晶圆的同步扫描,结合高数值孔径投影物镜,可以实现大面积高分辨率图形转移。通过多轴高精度晶圆台与掩模台协同控制,降低大尺寸晶圆曝光中的像差与畸变,广泛用于先进工艺节点的批量生产。

(ASML KrF 步进扫描光刻机实景图)
技术指标亮点
Ø技术参数:分辨率≤110nm,套刻精度≤15nm,CD 均匀性≤8nm,镜头数值孔径:0.55-0.80(variable),最大曝光面积:26mm×33mm 。
Ø技术优越性:≤8nm 的 CD 均匀性显著降低因尺寸偏差导致的良率损失,支持模拟芯片等高性能稳定性要求的器件制备;≤15nm 的套刻精度保障多层光刻图案精准叠加,适配先进节点工艺,支持多层复杂器件制备。
工艺能力及应用
Ø双尺寸多体系兼容:支持 6 英寸与 8 英寸晶圆,适配科研与中试需求。支持多材料体系晶圆,可用于 110nm 节点逻辑芯片(如 8 位 / 16 位 MCU)、存储芯片(如 NOR Flash)、MEMS 与传感器(如压力传感器)、射频与功率器件(如 GaAs、SiC 等化合物半导体器件)的制造。
Ø研发中试兼容:在科研方面,能支持新材料器件验证(如二维材料、钙钛矿器件、光电器件)、工艺创新研发(如光刻胶评估验证、光刻工艺优化);在中试阶段,可利用 8 英寸晶圆产能完成从实验室工艺到量产工艺的参数固化,缩短量产导入周期。
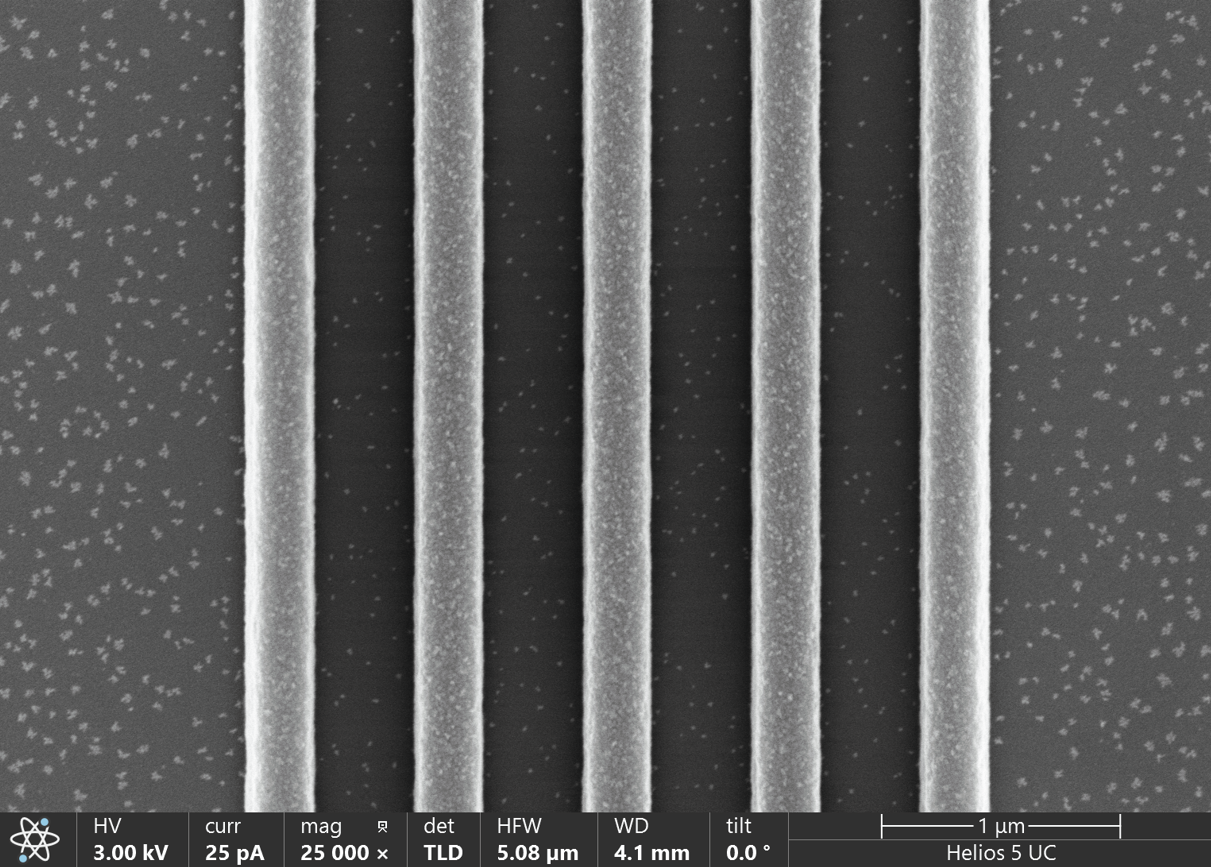
(ASML KrF 步进扫描光刻机工艺示例图)
此外,微纳平台将构建完整光刻工艺链,KrF 步进扫描光刻机作为中间环节,可与上下游设备快速衔接,实现 “涂胶 - 曝光 - 显影” 全流程自动化,并与接触式光刻机或者i-line步进式光刻机整合,形成从微米级到纳米级的完整光刻能力覆盖。